

— 贝博betball体育app下载 —
贝博betball体育app下载
来源:贝博betball体育app下载 发布时间:2024-03-01 07:49:52 人气:1
追溯芯片封装历史,将单个单元从整个晶圆中切割下来再进行后续封装测试的方式一直以来都是半导体芯片制造的“规定范式”。然而,随着芯片制造成本的飞速提升以及消费市场对芯片性能的不断追求,人们开始意识到革新先进封装技术的必要性。
对传统封装方式的改革创新,促成了晶圆级封装技术(Wafer Level Package,WLP)的“应运而生”。
晶圆级封装技术可定义为:直接在晶圆上进行大部分或全部的封装、测试程序,然后再来安装焊球并切割,产出一颗颗的IC成品单元(如下图所示)。
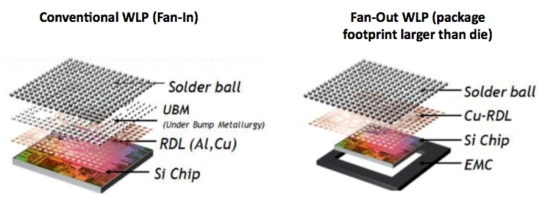
晶圆级封装技术与打线型(Wire-Bond)和倒装型(Flip-Chip)封装技术相比,能省去打金属线、外延引脚(如QFP)、基板或引线框等工序,所以具备封装尺寸小、电气性能好的优势。
封装行业的领跑者们大多基于晶圆模式来批量生产先进晶圆级封装产品,不但可利用现有的晶圆级制造设备来完成主体封装制程的操作,而且让封装结构、芯片布局的设计并行成为现实,进而显著缩短了设计和生产周期,降低了整体项目成本。
优化电、热特性,非常适合于射频/微波、高速信号传输、超低功耗等应用;4.
封装尺寸更小、用料更少,与轻薄、短小、价优的智能手机、可穿戴类产品达到完美契合;5.
PCB或基板(Substrate)互连的关键技术。凸块的选材、构造、尺寸设计,受多种因素影响,如封装大小、成本及电气、机械、散热等性能要求。

FIWLP)技术,业内亦称晶圆级芯片规模封装(Wafer Level Chip Scale Package,WLCSP)技术,是当今各类晶圆级封装技术中的主力。近两年,扇入型晶圆级封装产品的全球出货量都保持在每年三百亿颗以上,主要供给手机、智能穿戴等便携型电子科技类产品市场。
I/O)信号接口的数目大幅度的增加,凸块及焊球间距(Bump Pitch & Ball Pitch)的精密程度要求渐趋严格,再分布层(RDL)技术的量产良率也因此越发受重视。在这种背景下,扇出型封装(Fan-Out Wafer Level Package,FOWLP)及扇入扇出混合型(Hybrid Fan-In/Fan-Out)等高端晶圆级封装技术应运而生。下图所示为FIWLP(左)、FOWLP(右)的典型结构:

Re Distribution Layer, RDL)技术大多数都用在在裸芯(Bare Die)和焊球之间重新规划(也可理解为优化)信号布线、传输的路径,以达到将晶圆级封装产品的信号互联密度、整体灵活度最大化的目的。RDL的技术核心,简单来说就是在原本的晶圆上附加一层或多层的横向连接,用来传输信号。
值得注意的是,在该方案中有两层电介质(Dielectric)材料,用来保护被其包裹的RDL层(可理解为应力缓冲)。另外,凸块冶金(Under Bump Metallurgy,UBM)技术在这里也派上了用场,来帮助触点(Contact Pad)支撑焊球、RDL还有电介质。
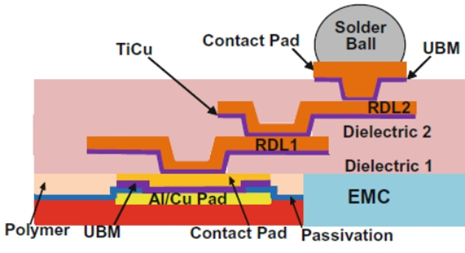
MCM)乃至系统级封装(SiP)产品在5G、AI、高性能运算、汽车无人驾驶等领域的普及,2.5D和3D晶圆级封装技术备受设计人员青睐。下图所示为2.5D(左)和3D(右)晶圆级封装技术。
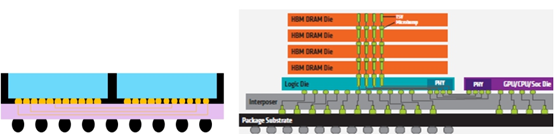
CPU、GPU、ASIC、PHY的信号互联,也可通过再分布层(RDL)或硅介层(Silicon Interposer)技术来实现。但是,3D堆叠起来的多个高带宽存储(High-Bandwidth Memory,HBM)芯片与其底部的逻辑类芯片的信号互联,则由硅穿孔(Through Silicon Via,TSV)技术来实现。当然,以上几种互联(Interconnect)如何取舍,需根据实际规格、成本目标具体问题具体分析。
集微网消息,Yole Development最新预估显示,2017年全球先进封装供应商排名中,中国长电科技将以 7.8%的市占率超过日月光、安靠(Amkor)、台积电及三星等,成为全世界第三大封装供应商。 2015年借助国家集成电路产业投资基金的推动下,长电科技耗资7.8亿美元杠杆并购了全球第四大封装公司星科金朋,目前已形成了包括星科金朋新加坡厂、星科金朋韩国厂、长电先进、星科金朋江阴厂(JSCC,原星科金朋上海厂)、长电科技(本部IC事业中心)、滁州厂、宿迁厂在内的7大生产基地,拥有世界领先的封装技术和覆盖全球的高端客户。 通过收购,长电科学技术拥有晶圆级封装(WLCSP)、系统级封装(SiP)、堆叠封装(PoP)等高端先进封装技术,
2021年4月14日,中国上海——长电科技任命林敬明先生担任公司高级副总裁,全面负责全球销售业务,直接向首席执行长郑力先生汇报。 近两年来,长电科技通过加强专业化管理、提高运营效率、优化资源布局和持续创新,为公司健康和高质量的发展奠定了坚实基础。随着半导体市场需求的多样化,长电科技需要一个更为优秀的销售团队倾力为全球客户提供最佳的专业支持和服务,对此,林敬明先生表示:“这是我职业生涯中一个很重要的决定。半导体行业正面临难得的历史发展机遇,长电科技在这个行业中的龙头地位,特别是长电科技管理团队的策略和理念,以及我自己对半导体产业链的理解、经验和热爱,都让这个决定变得理所当然。我将与团队一起,为我们的新客户和老客户伙伴提供一流的服务和支
侵权科技型标杆企业,维护行业有序竞争——长电科技继续推进甬矽电子系列侵权案 2022年2月17日,中国,上海——江苏长电科技股份有限公司(下称 “长电科技” )声明,针对甬矽电子(宁波)股份有限公司(下称 “甬矽电子” )侵犯长电科技合法权益的系列法律行动,目前已得到法院、仲裁机构或国家知识产权局的受理或正在审理过程中。长电科技将发起进一步的法律行动。 针对长电科技在2021年11月24日递交的举报材料,上海证券交易所要求甬矽电子保荐人、发行人律师等进行核查。长电科技认为,保荐人等于2022年2月14日披露的“核查报告”未能审慎核查并回复一些重大关注事项,包括: 1.成立于2017年11月的甬矽电子如何在短短
6月25日,上交所正式受理了苏州德龙激光股份有限公司(以下简称:德龙激光)科创板上市申请。 招股书显示,德龙激光致力于激光精细微加工领域,聚焦于半导体及光学、显示、消费电子及科研等应用领域,为客户提供激光加工解决方案。 其中,在半导体领域,德龙激光成功进入国内最大的半导体设计企业华为海思;国内最大的半导体制造企业中芯国际;国内最大的半导体封装测试企业长电科技;第三代半导体器件厂商代表企业华润微、泰科天润、能讯半导体等。 在显示领域,根据CINNO Research统计,2016-2020年中国大陆主要面板厂的激光切割类设备数量,德龙激光销量占比为12%,排名第三。其客户包括群创光电、深天马、维信诺、京东方、信利公司、华星光电等
/海思供应商德龙激光科创板IPO获得受理 /
电子网消息,韩媒报导,三星电子2018年将开发新半导体封装制程,企图从台积电手中抢下苹果处理器订单。 面对三星强势抢单,台积电表示,不评论竞争对手动态,强调公司在先进制程持续保持一马当先的优势,对明年营运成长仍深具信心。 三星与台积电先前曾分食苹果处理器代工订单,之后台积电靠着前段晶圆制造能力和新封装技术,于2016年独拿苹果所有订单。 台积电供应链分析,台积电7nm制程发展脚步领先三星,且与苹果的合作伙伴关系稳固,挟制程领先、产能业界之冠,以及高度客户信任关系等三大优势下,台积电明年仍将以7nm制程,独拿苹果新世代处理器订单, 未来也将是苹果最重要的处理器代工合作伙伴。 南韩网站etnews引述业界消息报导,三星旗下半导体事业部门正投资发
随着信息数据大爆炸时代的来临,市场对存储器的需求持续增长。在芯片成品制造环节中,市场对传统打线封装的依赖仍居高不下。 市场对使用多芯片堆叠技术、来实现同尺寸器件中的高存储密度的需求也日渐增长 。这类需求给半导体封装工艺带来的不仅仅是工艺能力上的挑战,也对工艺的管控能力提出了更高的要求。 作为半导体封测领域领军企业, 长电科技 在多芯片堆叠封装技术领域有哪些创新实践?本文中将介绍其技术优势、工艺和管控能力等内容。 多芯片堆叠封装技术优势 图1是两个不一样的存储器封装的侧视图,从其封装结构我们大家可以看出,两个封装都是由多个芯片堆叠而成,目的是为减少多芯片封装占用的空间,以此来实现存储器件尺寸的最小化。其中较关键的工艺是
技术 /
传统的MEMS长期依赖陶瓷封装,虽然行之有效,但MEMS产业已经酝酿向晶圆级封装(WLP)技术转变,而这一转变的部分驱动力则来自于慢慢的变多的晶圆代工厂开始涉足于MEMS领域。 “TSMC(台湾新竹)和一些其他的晶圆代工厂已经在谈论在未来制造MEMS部件,” MEMS封装专家、ET-Trends(罗德岛,West Greenwich)的创始人Ken Gilleo这样介绍,“他们也同样拥有制作封装所需的资源。如果他们决定进入这一领域,他们会更倾向于直接进行晶圆级封装。因而大型晶圆代工厂可能最终成为创新型MEMS封装的主角。” Yole Développement(法国,里昂)的一名分析师Jerome Baron说:“当
中国上海,2011年10月20日 —— 恩智浦半导体NXP Semiconductors N.V. 近日宣布其LD6806CX4超低压差稳压器(LDO)开始供货。该产品具有超低压差的特性,在200-mA额定电流下压降仅为60 mV。LD6806CX4采用超小型0.76 x 0.76 x 0.47mm晶圆级芯片级封装 (WLCSP),所占用的电路板空间极小,是设计尺寸有限且对电池使用寿命要求极高的移动电子设备的理想之选。 手机电池的放电几乎与时间呈线性关系,但LDO能够最终靠提供恒定的稳压输出电压,从而有效地改善这样的情况。举例来说,假如一部智能手机的电池电压下降至3.0 V,具有低压差电压特性的LD6806CX4仍旧能在2.9 V的强制稳
技术与可靠性 (阿德比利)
FanySkill安装使用说明 For Allegro 16.617.2版本
【电路】采用小型5x5 PowerPAKâ封装的新款同步降压稳压器,你了解吗?
报名赢【养生壶、鼠标】等|STM32 Summit全球在线大会邀您一起解读STM32方案
MPS电机研究院 让电机更听话的秘密! 第一站:电机应用知识大考!第三期考题上线,跟帖赢好礼~
有奖直播 同质化严重,缺乏创新,ST60毫米波非接触连接器,赋予你独特的产品设计,重拾市场话语权
梅开二度续写合作新篇章,聚力迈向数字化转型未来2024年2月29日,中国上海 日前,全球领先的国际化功率器件品牌瑞能半导体(以下可简 ...
一年以来,半导体行业发生了翻天覆地的变化,为了适应外部变化,许多公司选择改变方针或打法,换帅、重组……这些事件在最近一段时间内频繁发生。...
2024年2月29日【山东,济南】2月29日,美的光伏以“光生万物、智慧未来”为主题亮相亚太地区最具影响力的分布式能源全产业链行业盛会,2024 ...
2 月 29 日消息,英特尔 CEO Pat Gelsinger 最近在接受 TechTechPotato 采访时,毫不掩饰地表示:“我将整个公司都押注在了 18A ...
欧洲四大机构联手成立RTO联盟,斥资1.56亿欧元推动300毫米代工技术
欧洲四家顶尖的深度技术探讨研究机构IMEC、Leti、Fraunhofer和VTT,已共同成立名为RTO的联盟,并计划投入1 56亿欧元,以协调和互补的方式推 ...
晶心科技与元视芯打造全球首款采用RISC-V的车规级CMOS图像传感器
AI持续发热,Arm新一代Neoverse CSS V3和CSS N3为客户释放最优性能
2021年亚洲供应链市值百强:大陆半导体企业上榜9家合计市值2091亿美元
免费体验业界最快编译速度&最好性能 Quartus II v15.0网页版下载有礼!
抢楼啦!一波儿精品教程来袭,评论转发教程有礼!为2019国赛打气助力~
有奖直播报名:TI DLP技术在汽车行业的创新应用——增强型抬头显示
半导体生产材料技术封装测试工艺设备光伏产业平板显示EDA与IP电子制造视频教程词云:
相关推荐